|
И. Катеринич, В. Попов Метод для диагностики технологического процесса изготовления МОП ИС с использованием радиационно-термических процессовПл╦нки оксида кремния (SiO2) на кремнии в настоящее время широко используются в планарных изделиях - полупроводниковых приборах (ПП) и интегральных схемах (ИС) на их основе. Качество оксидной пл╦нки в значительной степени определяет такие характеристики ПП и ИС, как процент выхода годных изделий в производстве и над╦жность при эксплуатации. Одной из основных характеристик этих пл╦нок является их дефектность, то есть плотности дефектов в объ╦ме оксида и на его границе раздела с кремнием. Эти дефекты накапливают заряд как в процессе производства планарных изделий, так и при их эксплуатации. Наиболее сильно эффект накопления заряда проявляется при эксплуатации в условиях воздействия проникающей радиации (на борту космических аппаратов, рядом с ядерно-энергетическими установками и т.п.) [1]. Чувствительность ПП и ИС к воздействию радиации представляет интерес не только с точки зрения работоспособности ПП и ИС в аппаратуре специального назначения, но и как средство диагностики дефектности оксидных пл╦нок в планарных изделиях. В связи с этим обращает на себя внимание метод радиационно-термической обработки (РТО) [2]. Применение РТО в технологическом маршруте изготовления МОП ИС для обеспечения высокого процента выхода годных изделий и их над╦жности показало отличные результаты [2,3]. Поскольку введение новых технологических маршрутов изготовления ПП и ИС на начальном этапе требует проведения большого объ╦ма экспериментальных исследований различных технологических версий в довольно ограниченные сроки, то необходимо применять очень информативные и не требующие значительных временных затрат методы. В настоящей работе для анализа качества оксидных пл╦нок при контроле технологического процесса или при отработке новых его вариантов предлагается метод РТ-характеристик, базирующийся на векторном описании результатов проведения РТО и позволяющий получить также оценку радиационной чувствительности параметров исследуемых образцов в наглядном виде в условиях многофакторного эксперимента. Дефекты оксида кремнияПл╦нка оксида кремния, используемая в планарных приборах, по атомарной структуре занимает промежуточное положение между кристаллическим кварцем и аморфным стеклом. В ней имеет место ближний порядок (атомы кремния и кислорода имеют ковалентные связи и чередование: Исследования методом электронного парамагнитного резонанса (ЭПР) Герасименко Н.Н. [6] показали доминирование в пл╦нках оксида кремния двух видов дефектов. На рис. 1а представлены графики, характеризующие отжиг этих центров. Один из них - Е'-центр представляет вакансию мостикового кислорода ( Рисунок 1. Результаты исследования дефектов оксида кремния: а) методом ЭПР (отжиг Е`-центров (1) и DI-центров (2)); б) методом ТСТ (пик 1 - Е`-центры и пик 2 - DI-центры)
Методом ЭПР исследовались и дефекты на границе раздела (поверхностные состояния - ПС), названные Pb-центрами [7]. В отличие от ОС, которые являются главным образом ловушками дырок и сохраняют свой заряд продолжительное время (месяцы и годы), ПС захватывают как дырки, так и электроны и обмениваются зарядом с приповерхностной областью полупроводника. Другие методы исследования также показывают доминирование двух видов дефектов оксида кремния. Так, например, метод термостимулированных токов позволил выявить два пика, соответствующих разным дефектам вблизи границы раздела кремний √ оксид кремния (ПС), и определить энергии активации процесса термического выброса заряда из них. Результаты экспериментального исследования этим методом, взятые из [8], представлены на рис. 1б. Прич╦м по энергии активации левый пик соответствует Е'-центру, а правый - DI-центру. Использование метода изотермического отжига МОП-транзисторов (МОПТ) после облучения гамма-лучами (метода РТО) авторами данной работы также показало наличие двух типов дефектов оксида кремния. Метод заключается в разбиении облученных образцов МОПТ на группы, каждая из которых подвергалась термообработке при фиксированной температуре. Экспериментальные зависимости относительного изменения порогового напряжения МОПТ при термообработке, соответствующие отжигу накопленного при облучении заряда в ОС, и результаты расч╦та энергии активации процесса термического выброса заряда с энергетических уровней дефектов, представленные на рис. 2, показывают соответствие этих результатов для ОС данным, полученным методом термостимулированных токов для ПС. На этом рисунке n = Uon(T,t)/Uon(D), где Uon(D) и Uon(T,t) - значения пороговых напряжений МОПТ после облучения дозой D и после низкотемпературного отжига при температуре Т и в течение времени t. Рисунок 2. Результаты исследования дефектов оксида кремния методом изотермического отжига заряда в них после облучения гамма-лучами: а) результаты отжига заряда; б) результаты расч╦та энергии активации процесса отжига заряда
На рис. 3 представлены результаты исследования МОПТ с использованием метода РТО. На этом рисунке по оси ординат отложено относительное изменение порогового напряжения Q(t) = [Uon(T,t) √ Uon(0)]/[Uon(D) √ Uon(0)], где Uon(0), Uon(D) и Uon(T,t) - значения порогового напряжения до облучения, после облучения дозой D и после термообработки при температуре T в течение времени t. Метод РТО позволил также наблюдать аномальный процесс (рис. 3), при котором один из образцов МОПТ, подвергавшийся термообработке при 400оС, изменил направление дрейфа порогового напряжения. Это явление обусловлено пострадиационным эффектом [9] - накоплением заряда в макродефекте тестовой МОП-структуры при термообработке после облучения. Аналогичный эффект в МОП-транзисторах исследовался в [10]. Рисунок 3. Относительное изменение порогового напряжения nМОПТ после облучения при термообработке при 100ºС ( О ), 200ºС ( Ф ), 300ºС (
Таким образом, метод РТО позволяет выявлять не только точечные дефекты, но и макродефекты оксидной пл╦нки и является перспективным средством диагностики качества технологического процесса. Метод диагностикиСуть предлагаемого в данной работе метода заключается в следующем. Для исследуемых образцов (тестовых элементов или изделий в целом) определяют совокупность информативных параметров ({Пi}, i = 1,m). Далее образцы подвергаются радиационно-термической обработке в заданных режимах с измерением значений информативных параметров до РТО (Пio), после облучения (Пig) и после термообработки (Пiт). По данным измерений для каждого информативного параметра Пi исследуемого образца строится РТ-характеристика (рис. 4). Под РТ-характеристикой понимается представление результатов процесса облучения и термообработки в виде точки Ai(Пig √ Пio; Пiт √ Пio) в системе координат, где абсцисса Пig √ Пio = Рисунок 4. РТ-характеристики процесса РТО для МОПТ и их векторное представление (D - этап облучения, Т - этап термообработки)
Точка Аi, согласно рис. 4, может рассматриваться как конец вектора ОАi, называемого обычно радиусом-вектором ri точки Аi и имеющего те же координаты, что и точка Аi: ri = {Пig √ Пio; Пiт √ Пio}. Поэтому ri можно рассматривать как векторное представление результатов проведения РТО. Компоненты (геометрические проекции) вектора ri по осям координат представляют собой векторное описание результатов проведения процессов радиационной обработки (rix) и последующей термообработки (riy) с координатами rix = {Пig √ Пio ; 0} и riy = {0; Пiт √ Пio}, отражающими в виде параметрического отклика результат проявления радиационных эффектов в пл╦нке оксида кремния и их последующего отжига. В зависимости от конкретных режимов РТО, будут изменяться модуль вектора и угол его наклона к оси абсцисс. При этом:
где Исследование кинетики термического отжига показывает, что интенсивность процесса отжига обратимых радиационных эффектов существенно зависит от температуры отжига, а поведение
где t - время отжига, м = B exp(-Ea/kT), где Ea - энергия активации процесса отжига, В - частотный фактор, k - константа Больцмана, равная 8,63╥10-5 эВ/К. Что касается величины Возможные варианты изменения информативного параметра при РТО, отражающие процессы накопления и отжига заряда дефектов при D = const и Т = const, и пример расположения вектора ri на координатной сетке показаны на рис. 4. Как видно из этого рисунка, построение РТ-характеристик позволяет получить информацию не только о радиационной чувствительности информативных параметров ( Применение методаДля диагностики качества технологии МОП ИС наиболее удобно проводить анализ порогового напряжения тестового МОПТ с п-каналом. Как известно [1], пороговое напряжение МОПТ определяется как Uon = (Uon)i + где (Uon)i - пороговое напряжение при идеальной (бездефектной) структуре кремний √ оксид кремния, Рисунок 5. Общий вид дозовой зависимости порогового напряжения МОПT с n-каналом
Для анализа радиационной чувствительности Uon использовались результаты облучения в пассивном режиме изготовленных пластин с тестовыми МОПТ от источника гамма-излучения 60С до дозы 106 рад(Si) при мощности дозы 136 рад(Si)с-1 и результаты последующей термообработки этих пластин при 400ºС в течение 30 мин. На рис. 6 представлено поле РТ-характеристик порогового напряжения (Uon) исследовавшихся МОПТ. Как следует из этого рисунка, наиболее качественной является технологическая версия 3. Радиационная чувствительность образцов МОПТ, изготовленных по этой технологии, невысокая и отличается достаточной однородностью, а динамика изменения Uon в ходе РТО указывает на преобладающую роль ПС в структуре системы Si√SiO2. В процессе термического отжига образцов, изготовленных по технологии версии 3, отжигаются не только заряд в дефектах, но и часть самих технологических (производственных) дефектов изготовленных структур, о ч╦м свидетельствует характер динамики Uon и расположение РТ-характеристик на плоскости (обл. I).
Радиационно-стимулированные процессы накопления заряда в ОС и образования радиационных дефектов, а также их отжига в структурах, изготовленных по технологической версии 1, более разнообразны. Как можно видеть на рис. 6, этой технологии присущи механизмы, связанные с процессами дефектообразования в подзатворном оксиде при облучении. Наблюдается неполный отжиг радиационного заряда дефектов при термообработке (обл. II), полный отжиг радиационного заряда дефектов и части самих технологических (производственных) дефектов подзатворного оксида (обл. IV), а также процесс зарядки макродефектов (обл. III). Кроме того, данный технологический процесс по радиационной чувствительности порогового напряжения характеризуется большим разбросом, чем технология версии 3. Наибольшей радиационной чувствительностью n-канальных МОПТ обладает технологическая версия 2 изготовления образцов (рис. 6), что свидетельствует о высокой плотности технологических дефектов в подзатворном оксиде кремния. Таким образом, полученные в ходе экспериментальных исследований результаты подтверждают перспективность применения метода РТ-характеристик для анализа качества технологических процессов и возможность его использования при сертификации технологий. Таблица. Процессы в МОПТ при РТО
Литература
|
|||||||||||||||||
|
|
 |
 |
PDFs | Новости | Литература | Схемы | Форум | Блоги | Реклама |
 Метод для диагностики технологического процесса изготовления МОП ИС с использованием радиационно-термических процессов.
Метод для диагностики технологического процесса изготовления МОП ИС с использованием радиационно-термических процессов.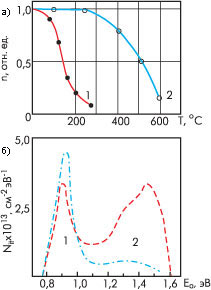
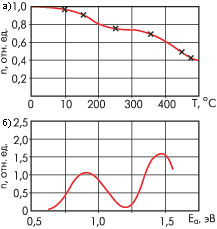
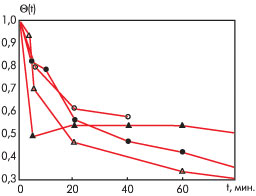
 Пig - абсолютное отклонение параметра Пi (относительно начального значения) после облучения до дозы Dg (радиационная чувствительность параметра Пi); a ордината Пiт √ Пio =
Пig - абсолютное отклонение параметра Пi (относительно начального значения) после облучения до дозы Dg (радиационная чувствительность параметра Пi); a ордината Пiт √ Пio =